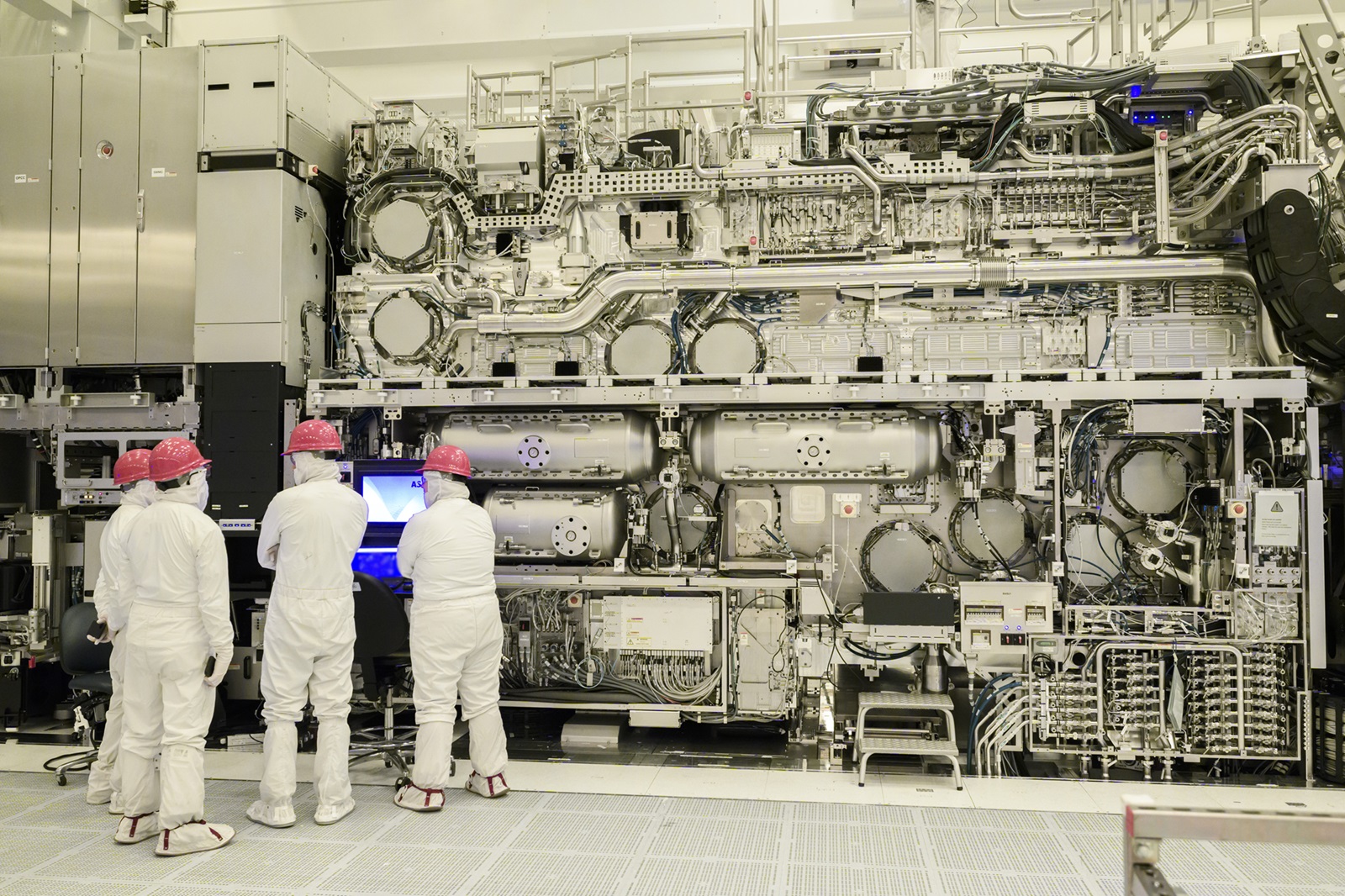
英特尔宣布,美国俄勒冈州希尔斯伯勒的研发基地中,已完成业界首台ASML供应的商用高数值孔径极紫外光微影设备(High NA EUV)组装,型号为TWINSCAN EXE:5000。
该机台正在进行多项校准步骤,预计2027年启用,率先用于Intel 14A制程,协助英特尔推展未来制程蓝图。 此设备将投影印刷成像到晶圆的光学设计进行改造,明显提升下世代处理器的图像解析度和尺寸缩放。
英特尔计划于2025年Intel 18A的产品验证,以及未来Intel 14A的量产阶段,都会采用0.33和0.55数值孔径的EUV微影设备。
《高数值孔径极紫外光微影设备High NA EUV小科普》
高数值孔径极紫外光High NA EUV技术使用人工的13.5奈米光波长。 此一光波长是利用强大的雷射光束,照射加热至将近摄氏22万度的锡滴上而产生,此温度高出太阳表面平均温度40倍。 光束从含电路图案模板的光罩中反射,再穿过高精度镜组打造的先进光学系统。
NA(Numerical Aperture)数值孔径为衡量光收集和聚焦能力的重要指标,用在光学系统上,决定了光刻的实际图案解析度和缩小电晶体尺寸,以及能够做到的制程节点。 然而,要进一步制造尺寸更小的电晶体,仍需要全新的电晶体结构和相关制程步骤。
ASML目前的EUV曝光机NA只有0.33,对应的解析度为13nm,可以生产金属间距在38~33nm之间的晶片。 往下发展到金属间距缩小到30nm以下,也就是对应的制程节点在5nm以下,解析度就不够了。 或者是需要用多重曝光(pattern shaping)技术来辅助,会导致成本增加且影响良率。
ASML新一代的高数值孔径EUV设备EXE:5000可以做到0.55 NA,解析度缩小到8nm。 相较于0.33数值孔径的EUV微影设备,高数值孔径EUV微影设备(或0.55数值孔径的EUV微影设备)可为类似的晶片尺寸提供更高的成像对比度,可减少每次曝光所需 的进光量,并缩短每层列印时间,从而提高晶圆厂的产能。
采用第一台高数值孔径EUV的英特尔指出,当High NA EUV微影设备与英特尔晶圆代工服务的其他领先制程技术相结合时,列印尺寸预计将比现有EUV机台缩小1.7倍。 由于2D尺寸缩小,密度将提高2.9倍,英特尔将持续引领半导体产业发展更小、更密集的图案化(pattterning)技术,进一步延伸摩尔定律。
《台积电为什么不急着导入高数值孔径EUV? 》
过去半导体进入EUV时代,全球也是三星第一个先使用EUV设备的Foundry厂,台积电第一代7nm制程仍是用多重曝光,第二代才改用EUV技术。
电晶体架构从FinFET(鳍式场效电晶体)转换到GAA(环绕闸极场效电晶体)架构,竞争对手三星、英特尔都在3nm制程抢着采用GAA电晶体,台积电直到2nm制程才会改采 GAA电晶体架构,预计2025年量产。
从EUV技术导入、采用GAA电晶体,一直到使用高数值孔径EUV技术等历程,可以看出台积电的作风偏向谨慎保守,不会冲第一个采用新技术。
台积电曾回应何时使用高数值孔径EUV设备时表示,技术本身的价值只有在为客户服务时,方能彰显出来。 每当新的工具或设备,台积电都会先研究,看看工具的成熟度和成本,再进一步评估如何去实现。
图说:ASML的TWINSCAN EXE:5000系统的总重量超过150吨,将先分装于250多个货箱中,并集中装入43个货柜,货柜由多架货机运送至西雅图,再利用20辆卡车 运输到俄勒冈州。 一台售价将近4亿美元! ! !